執筆:小川紘樹(京都大学)
散乱測定法は、試料から散乱するX線を検出することで、非破壊で内部の構造を計測する手法
X線散乱法とは、試料に対してX線を入射することで、散乱したX線を検出器で得る手法です。散乱する角度により、オングストロームからナノメートルのサイズ・形状・構造相関などを非破壊で得ることができます。さらに、例えば小角X線散乱法(SAXS)は透過型である一方で、斜入射小角X線散乱法(GISAXS)は、非破壊で薄膜の内部や界面の深さ方向のナノ構造を調べる方法であり、薄膜試料内部の構造情報を測定できます。
測定できること
原子・分子の構造 /原子・分子の集合体によるメゾ構造/ 形状 / 分布 / 界面構造 / 構造体間の平均距離
原理
X線散乱法とは、試料に対してX線を入射することで、散乱したX線を検出器で得る手法です。散乱する角度により、広角散乱、回折(WAXS,WAXD)、中角散乱(MAXS)、小角散乱(SAXS)、超小角散乱(USAXS)と区別され、試料内部の構造情報 (オングストロームからマイクロメートルのサイズ・形状・構造相関など) を幅広くカバーしています。さらに、試料の状態についても、バルク、溶液、繊維から薄膜などを非破壊で測定でき、さらには温度やせん断などを試料に加えられる試料装置を用意すれば、外場応答に対する時間発展測定も可能です。例えば、一般におおよそ5°以下の散乱を測定する手法を小角散乱 (SAXS) 法と呼びます。1 ~ 100nmのサイズを有し、高分子間での電子密度差 (散乱コントラスト) が生じた時の構造評価が可能になります。図1に、代表的なラボ用でのSAXS装置を示します。
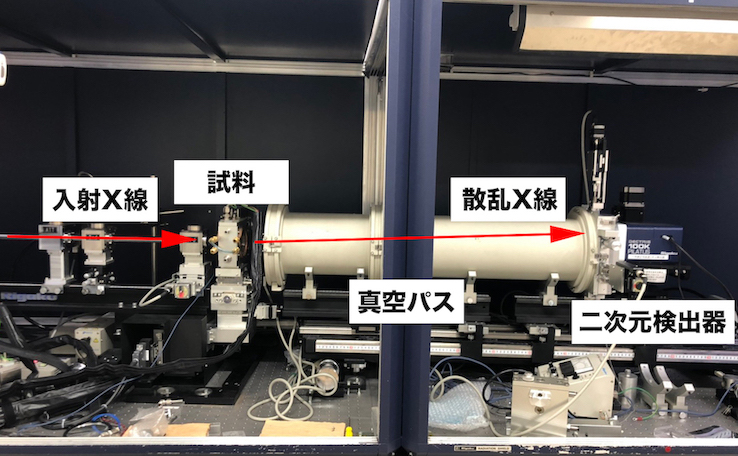 図1 ラボSAXS装置のレイアウト
図1 ラボSAXS装置のレイアウト
ラボ装置の小角X線散乱測定では、CuKαの特性X線 (波長
λ = 0.15418nm) を試料に照射します。試料から散乱されたシグナルは真空パスを経由して、二次元検出器において像を取得します。真空パスは、散乱シグナルの減少や空気散乱によるバックグラウンドの上昇を防ぎます。X線の波長を
λとし、構造サイズを
dとすると、散乱角2
θとの関係は、
λ = 2
dsin
θと表されます。そのため、小さい散乱角2
θの測定は大きな構造
dを測定することに対応しています。真空パスの長さを数十cmから2m程度まで任意に変えることで、測定したい2
θの範囲を変えることができます。得られた散乱強度のプロファイルを解析するには、例えば、横軸を散乱ベクトル
qとし、縦軸に散乱強度として一次元プロットにします。散乱ベクトル
qは、
q = (4π/
λ)×sin
θで定義されます。縦軸のX線散乱強度は、干渉性散乱による系全体からの散乱であり、系の電子密度分布の自己相関関数とはフーリエ変換の関係があります。構造体が孤立して存在する場合は、1個の構造体からの散乱が観測されますが、構造体が多数存在する場合においては構造体間の干渉効果も散乱に寄与します。そのため、凝集系においては、X線散乱強度から構造体の平均サイズ・形状・分布・界面構造や、構造体間の平均距離を求めることができます
1)2)3)4)。
バルク試料については、上述の透過型のSAXS測定で構造情報が得られますが、斜入射型(斜入射小角X線散乱: GISAXS)にすることで、薄膜 (膜厚1μm以下) の内部や界面の深さ方向のナノスケール構造を非破壊で調べる方法です。測定対象としては、薄膜 (おおよその膜厚が1μmから数十nm程度) におけるブロック共重合体の自己組織化構造、多成分系の相分離構造、結晶性高分子のラメラ構造、液晶における構造やその配向、などが挙げられます。一般的には、これらの高分子薄膜をシリコンウエハなどの基板上において成膜した状態で測定します。本手法では、X線を高分子薄膜試料の全反射臨界角近傍 (0.05°~0.2°程度) の非常に浅い角度ですれすれに入射し、小角散乱測定を行う手法です(図2)。GISAXS法では、透過型SAXS法と比較して、以下の点が大きな特徴です。詳細な原理などについては、文献
5)を参考にしてください。
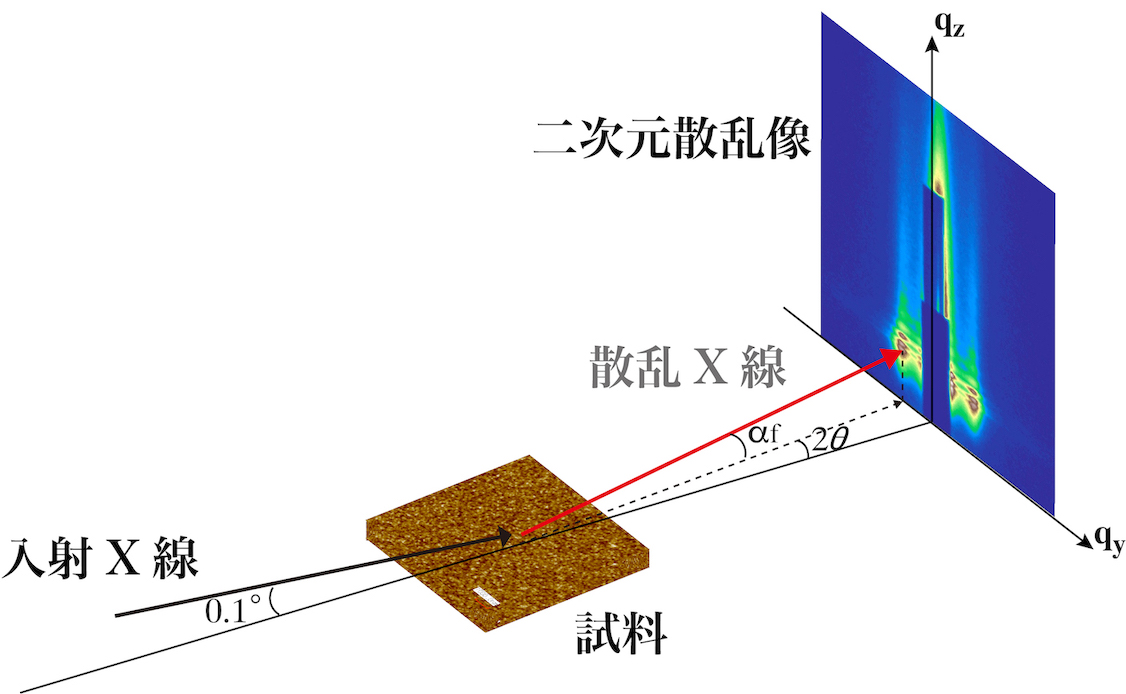 図2 斜入射小角X線散乱(GISAXS)の概略図
図2 斜入射小角X線散乱(GISAXS)の概略図
- 基板上の薄膜試料に対して、非常に浅い角度でX線を入射して測定します。
- 面内 (in-plane) と面間 (out-of-plane) 方向に異方性を持つ構造が評価できます。
- 反射型での測定であるため、表面・界面粗さとその相関が評価できます。
- すれすれ入射の配置では、入射角を全反射臨界角より浅い角度から臨界角の1.5倍程度までの角度に変化させることにより、試料へのビームの進入深さを変化させることが可能であり、各深さでの構造を調べることができます。
- 測定対象は薄膜試料で、基板上に成膜した状態です。この状態で、透過型SAXSで測定すると、試料の散乱体積が非常に小さく、かつX線が基板に吸収されてします。そのため、シグナルはほとんど得られません。すれすれの角度で入射することで、基板を透過することなくシグナルを得ることができます。また、入射角が浅いことで、入射X線方向において試料に照射される部分が伸びます (フットプリント)。そのため、散乱体積が増加しますので、シグナルを効率的に得ることができます。
- 面内及び面間方向における構造解析では、二次元像のビーム中心位置から基板面に対して並行方向に対応する赤道方向 (qy) 及び基板面に対して垂直方向方向に対応する子午線方向 (qy) に沿った散乱強度を別々に一次元プロットして解析します。In-plane方向におけるプロファイルでは、透過型SAXSと同じように解析することで構造評価が可能です。ただし、out-of-plane方向におけるプロファイルを解析する際には注意が必要です。その理由は、基板に垂直方向におけるシグナルは、散乱によるシグナルだけではないからです。試料に入射したX線は、内部おいて屈折と同時に反射します。特に、基板で反射したX線から散乱したシグナルも考慮に入れなければなりません。そのため、得られるシグナルはこれらの散乱、屈折、反射からのシグナルが重なって検出されます。さらに、それぞれの散乱シグナルのqz方向におけるベクトルも歪んでしまうからです (歪曲波ボルン近似: Distorted Wave Born Approximation, DWBA)。最近では、これらの効果を考慮したデータ解析ソフトが出てきています(例えば、FitGISAXS : https://pprime.fr/?q=fr%2Fnanoparticules-nanostructures)。
- の一例として、図3に入射角を変えた時の高分子薄膜へのX線の侵入深さを示します。全反射臨界角手前の0.05 °では数nmにしか侵入せず、最表面の構造のみを評価できるのに対して、全反射臨界角を超えた0.15 °では、約2000 nmまでX線が侵入するため表面を含めた薄膜内部構造の評価が可能になることが分かります。GISAXS測定を行うには、基本的には小角散乱測定ですので、透過型の小角散乱装置とほぼ同じ構成です。ただし、正確に入射角を調整するためのステージを試料位置に設置する必要があります。
 図3 波長0.1nmにおけるポリスチレン薄膜へのX線の入射角(αi )に対する侵入深さ
図3 波長0.1nmにおけるポリスチレン薄膜へのX線の入射角(αi )に対する侵入深さ
ラボ用のSAXS/GISAXS装置では、必要な時に測定できるという高い利便性があります。しかしながら、X線の輝度が低いため、十分な像を取得するのに数分から数時間程度必要になります。特に、薄膜試料はバルクと比較して散乱体積が小さく、必要な構造サイズ由来のシグナルが得られないこともあります。そのため、SPring-8 (Super Photon ring-8GeV:
http://www.spring8.or.jp/ja/) や PF (フォトンファクトリー :
https://www2.kek.jp/imss/pf/) に代表されるような大型放射光施設におけるSAXS/GISAXS測定が盛んに行われています。特にSPring-8が提供するX線の輝度は世界的にトップクラスであり、ラボ装置と比較すると桁違いに強力です(
http://www.spring8.or.jp/ja/about_us/whats_sp8/whats_sr/sp8_features/)。近年、SPring-8では高分子専用のSAXS/GISAXS装置が建設されており、高分子の構造研究に必要不可欠なツールとなっています図4 (
http://www.spring8.or.jp/wkg/BL03XU/instrument/lang/INS-0000001524/instrument_summary_view)
6)。
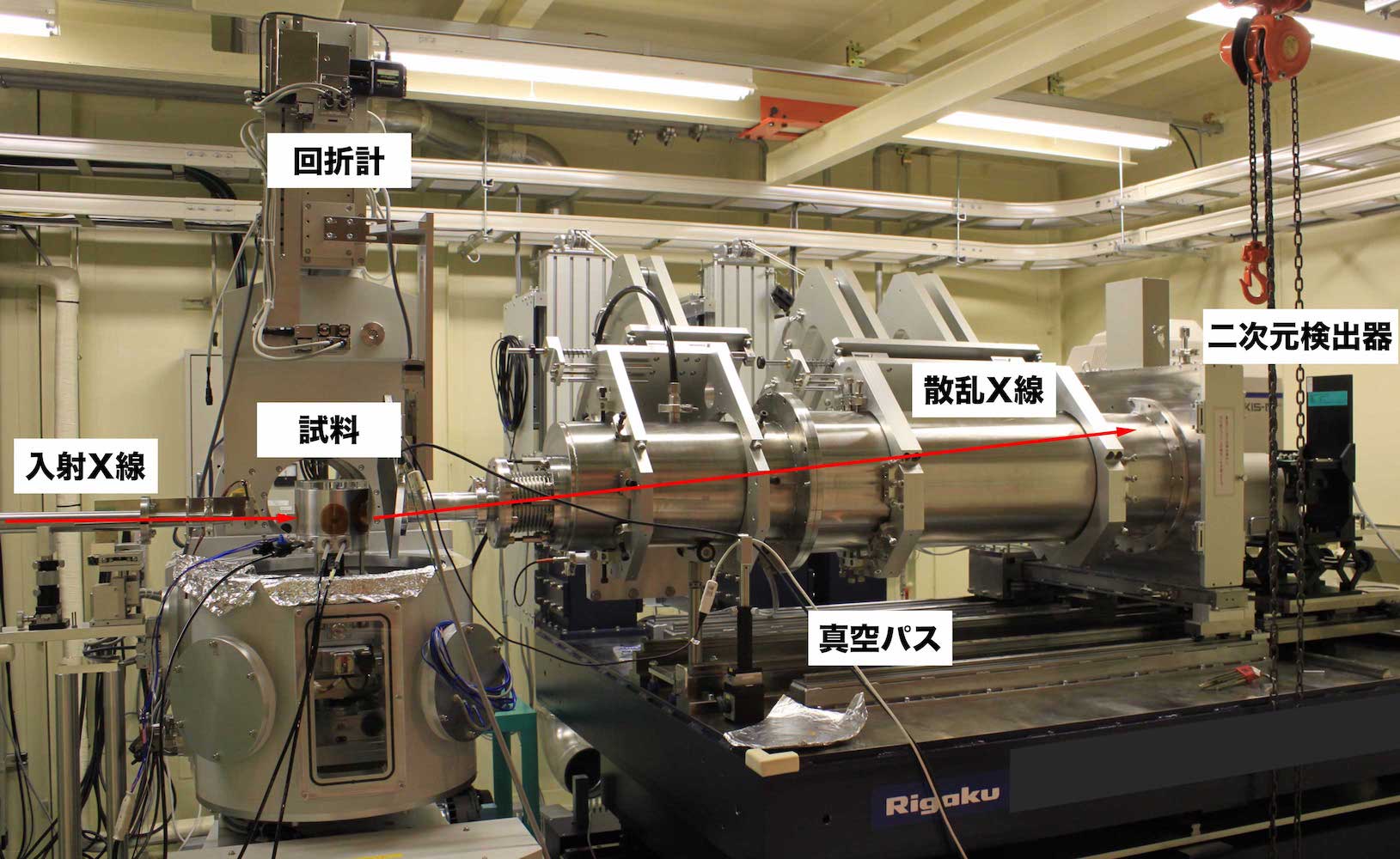 図4 SPring-8 BL03XUにおけるGISAXSレイアウト
図4 SPring-8 BL03XUにおけるGISAXSレイアウト
大型放射光施設におけるGISAXS装置を使うと、薄膜試料でも十分な像を取得するのに数ミリ秒から数秒しかかかりません。例えば、ポリスチレン−
b−ポリ2ビニルピリジン(PS−
b−P2VP) (
Mn = 40,000-
b-40,500,
Mw/
Mn = 1.08)のトルエン溶液を、シリコン基板上にスピンキャストにより膜厚約120 nmに製膜した試料の測定結果を図5に示します
7)。入射角が0.14°で、測定時間が1秒で得られた二次元像を図5(a)に示します。また、(b)には、表面AFM観察によって得られた像を示します。二次元像において、In-plane方向に二つの散乱ピークが観察されているのがわかります。この事は、膜内部において表面とは垂直な方向に周期的な構造を形成していることを示唆しています。図5(c)(d)には、二次元GISAXS像を
qz = 0.29 nm
-1の位置でin-plane方向にスライス、
qy = 0.14 nm
-1の位置でout-of-plane方向にスライスした各一次元プロファイルを示します。これらのプロファイルを解析した結果、直径30 nm, 長軸の長さが120 nmのシリンダー構造を形成していることがわかりました。
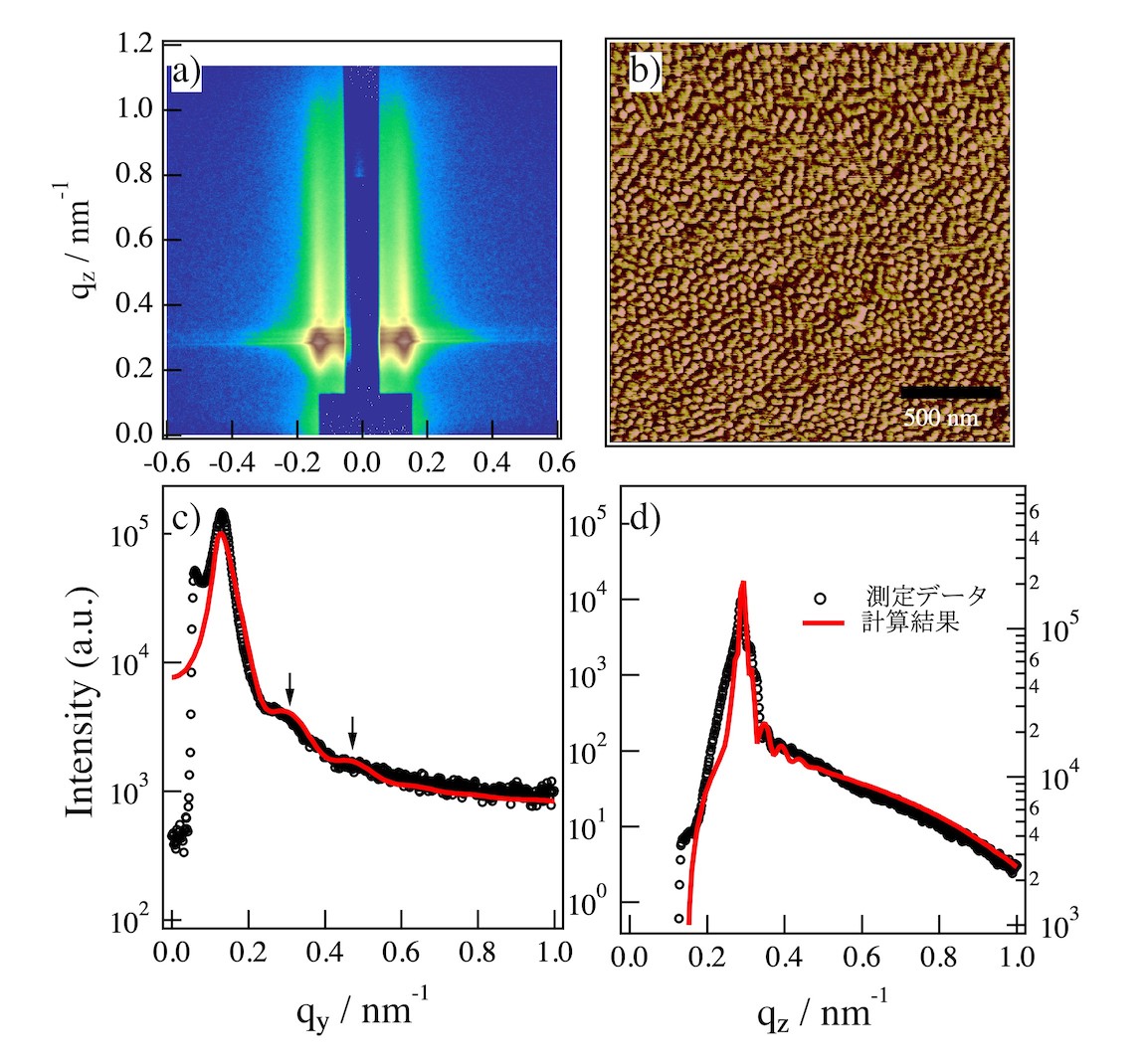 図5 PS-b-P2VP薄膜の(a)二次元GISAXS像と(b)表面AFM像.
図5 PS-b-P2VP薄膜の(a)二次元GISAXS像と(b)表面AFM像.
二次元GISAXS像の(c)in-plane及び(d) out-of-planeのプロファイルとフィッティング結果
また、放射光によるGISAXS装置では非常に短時間で二次元像が得られるため、溶媒が揮発する時の薄膜の成膜過程や温度などの外場変化に伴う構造の転移過程などをダイレクトに測定することが可能になります。例えば、上述のPS−
b−P2VPが揮発中においてシリンダー構造を形成する過程を直接観察することを試みました。スピンコート中の
in-situ測定を実施するためには、SPring-8のGISAXS装置に設置可能なコンパクトで且つ面精度が十分な専用のスピンコーターの開発が必要になります。そのため、面精度が2.5 μmの特殊スピンコーターの開発を行いました
8)。成膜は、直径2インチのシリコン基板を使用し、スピンコーターの回転数が2000 r.p.mにすることで約100 nmの膜厚が得られる条件で行いました。測定波長は0.1 nm、入射角は0.14°、カメラ長は約2.0 mで行い、検出器はイメージインテンシファイアとCCDカメラを用いました。二次元像を取得するための露光時間は45 ms、測定の間隔は60 msです。
 図6 スピンコート中の各時間における二次元GISAXS像
図6 スピンコート中の各時間における二次元GISAXS像
図6に、二次元散乱像の時間発展を示します。初期の90 msにおいては明確な散乱が観察されなかったのに対し (図6(a))、1485 msにおいては、リング状の散乱パターンが発現しました (図6(b)のA部分)。この要因は、P2VP成分がコア、PS成分がコロナとなるミセルを形成し、このミセル間距離に対応する周期が発現しているためです。その後揮発が進んだ2115 msには、ミセル由来の散乱ピークの強度が減少する代わりに、散乱スポットが発現しました (図6(c) のB部分)。これらの散乱スポットを解析した結果を図7に示します。X線が体心立方格子(BCC) (110)面から入射した時の計算結果より導出した各回折点の位置と、測定結果が良く一致していることから、揮発中にミクロドメインがBCC構造を形成していることが示唆されました。さらに揮発が進むと、BCC構造からの回折点の強度が減少し、2250 msから
qy = 0.15 nm
-1の位置にブロードな散乱ピークが発現しました (図6(d) のC部分)。以上の結果より、揮発に伴いミセル構造からBCC構造へと転移し、その後シリンダー構造へと転移することがわかりました。
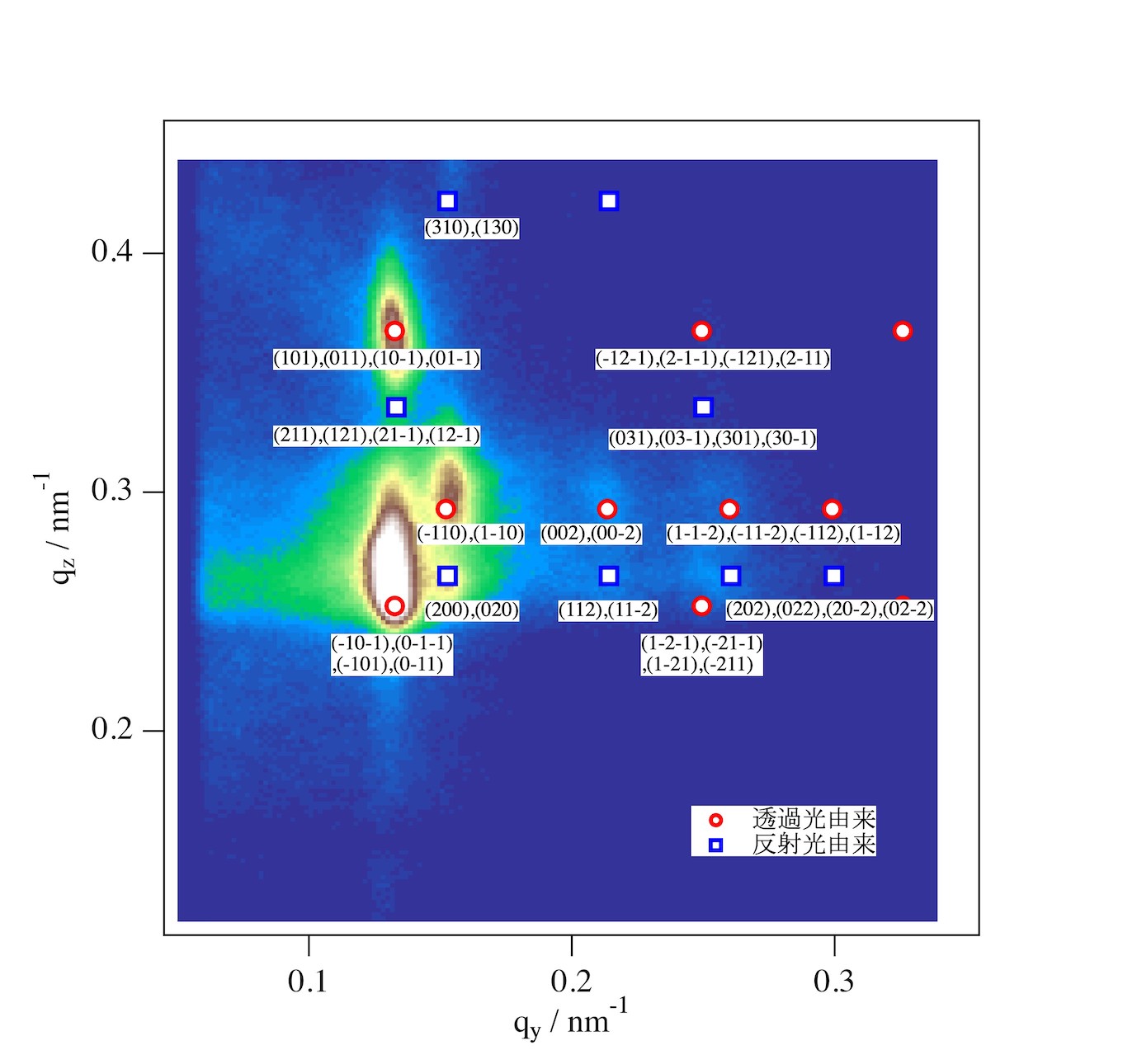 図7 二次元GISAXS像とBCC格子からの散乱スポット. 青丸は透過光の回折点、赤丸は反射光の回折点を示す.
図7 二次元GISAXS像とBCC格子からの散乱スポット. 青丸は透過光の回折点、赤丸は反射光の回折点を示す.
参考文献
1) 竹中幹人 X線散乱の基礎と新展開 日本ゴム協会誌 92 (2), 57-62 (2019).
2) 橋本竹治 X線・光・中性子散乱の原理と応用 2017 講談社.
3) 松岡秀樹 小角散乱の基礎~X線・中性子の小角散乱から何がわかるか~ 日本結晶学会誌 41 (4), 213-226, 1999.
4) 雨宮慶幸、篠原佑也 X線小角散乱の基礎と今後の展開 放射光Vol.19 No.6 338-348 (2006).
5) 桜井健次 X線反射率入門 2009 講談社.
6) Ogawa, H et al., Polym. J., 2013, 45, 109-116.
7) Ogawa, H et al. Macromolecules 2016, 49, 3471-3477.
8) Ogawa, H et al. J. Appl. Cryst., 2013, 46, 1610-1615.
分析例・プロトコール